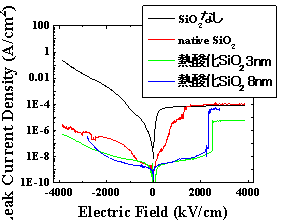
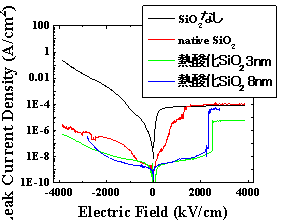
●
●
●
●
Intelの共同創業者ゴードン・ムーアが1965年に提唱した集積度が18〜24ヶ月で2倍になるという「ムーアの法則」に従い、近年集積回路の 微細化は進む傾向となっています。
集積回路の進化はチップの小型化、高速化、省電力化をもたらし、そのメリットを得るため、製造技術はますます進歩してきましたが、微細化によるある限界が見え始めてきました。
集積回路に用いる素子の一つにチップコンデンサがあります。微細化に伴い、コンデンサを形成する部分の面積Sも小さくなるので、ある一定の静電容量が保てなくなります。
以下の式に示すように、微細化により面積Sが小さくなると静電容量Cが小さくなります。静電容量が小さくなると閾値が定められなくなり、メモリとして利用することが出来ません。そこで現在3次元加工・high-kゲート絶縁膜の利用・相変化や磁性を利用したメモリなど新たなメモリ構造が模索されています。
これまでは試料作製時のターゲットはAl2O3で電荷蓄積層を作製する前後でチャンバを開閉し、試料が大気にさらされていましたがin-situで作製可能なAlを用い大気暴露することなく作製します。
基板−トンネル層間に熱酸化やスパッタリング法によりSiO2層を挿入することにより特性の改善を目指します。
メモリ構造
| Si substrate |
Al2O3 |
←ブロック層
←電荷蓄積層
←トンネル層
Al-rich Al2O3 |
Al2O3 |
Al gate electrode |
研究業績一覧
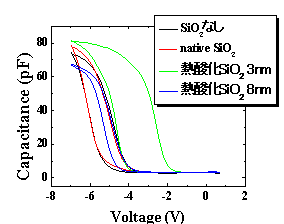
これまでの研究成果
Al-O薄膜の特徴
研究背景
今後の予定
| 静電容量の関係式。集積回路においてコンデンサは情報を記憶する種々のメモリとして利用します。 |
研究内容
メモリとして使用する材料として、Al(アルミニウム)の酸化物であるAl2O3(アルミナ)をよりAl-rich(アルミに近い組成)にすることで、メモリ効果を持つことが報告されているAl-Oという薄膜材料があります。
そこで本研究では絶縁膜トラップ型の不揮発性メモリとしてAl2O3,Al-O積層膜を作製し、種々の特性について評価していきます。